性能と効率の向上を目指した第3世代SiC MOSFETを電源設計に適用する方法
DigiKeyの北米担当編集者の提供
2022-11-02
産業用モータドライバ、AC/DCおよびDC/DCインバータ/コンバータ、バッテリチャージャ、エネルギー貯蔵システムなどのパワーアプリケーションでは、高効率、小型化、高性能への絶え間ない要求があります。これらの厳しい性能要件は、シリコン(Si)MOSFETの機能を凌駕し、シリコンカーバイド(SiC)をベースとした新しいトランジスタアーキテクチャの到来に繋がりました。
これらの新しいデバイスが主要な性能指標において大きな利点をもたらす一方で、さまざまな制約やアプリケーションの不確実性により、設計者が第1世代SiCデバイスに慎重になるのは賢明なことでした。第2世代デバイスでは仕様が向上し、デバイスの繊細な部分がさらに理解されるようになりました。SiC MOSFETの性能が向上し、市場投入までの時間に対する圧力が高まるにつれ、設計者はこれらの新しいデバイスを使用して製品目標を達成するようになりました。最近では、第3世代デバイスにより、SiCベースのパワーデバイスの成熟度が実証されています。これらのデバイスは、前世代におけるデザインインの経験や関連する専門知識に基づいて構築され、主要なパラメータの向上をユーザーにもたらします。
この記事では、SiとSiCを比較した上で、第3世代SiC MOSFETの開発と移行について説明します。その後、Toshiba Semiconductor and Storage Corp.(Toshiba)の実例を紹介し、これらのデバイスが電源システム設計の大幅な向上にどのように役立つかを示します。
シリコンとSiCの比較
過去数十年にわたり、シリコンベースのMOSFETは、基本電源やインバータからモータドライブに至るまで、電源システムの設計を一変させてきました。スイッチングが最適化されたSi MOSFETは、機能的に類似しているが構造や特性が大きく異なる絶縁ゲートバイポーラトランジスタ(IGBT)とともに、線形トポロジに基づく従来の非効率なパワー変換や管理から、スイッチ制御を使用したはるかに高効率で小型のアプローチへの移行を可能にしました。
これらの設計の大半では、パルス幅変調(PWM)の一形態を使用し、閉ループフィードバック構成で目的の電圧、電流、電力値を供給および維持します。シリコンMOSFETの使用増加に伴い、MOSFETへの要求も増えてきました。さらに、(多くは規制上の義務に基づく)新たな効率化目標、電気自動車やよりスマートなモータ制御の市場、再生可能エネルギーのパワー変換と関連するエネルギー貯蔵システムなどにより、これらのMOSFETにさらなる性能向上が求められてきました。
その結果、膨大な量の研究開発努力によってシリコンベースのMOSFETの性能が向上しましたが、研究者はこの努力が収穫逓減に近づいていることに気づきました。幸いなことに、理論的には、シリコンだけでなく、SiCを基板に使用したパワースイッチングデバイスをベースとする代替手段がありました。
SiCを使用する理由
さまざまな物理的理由から、SiCにはシリコンのみの場合と大きく異なる3つの重要な電気特性があり、それぞれの特性が動作上の利点をもたらします。その他にも、それほど目立たない違いがあります(図1)。
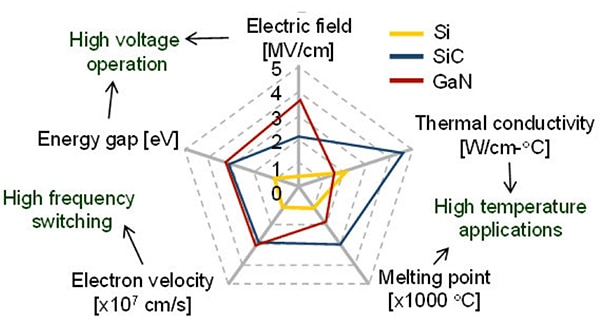 図1:SiCとSiおよび窒化ガリウム(GaN)固体材料の主要な材料特性の大まかな比較。(画像提供:Researchgate)
図1:SiCとSiおよび窒化ガリウム(GaN)固体材料の主要な材料特性の大まかな比較。(画像提供:Researchgate)
主に、以下3つの特性があります。
- Siでは破壊電界強度が1センチメートルあたり0.3メガボルト(MV/cm)なのに対し、SiCでは2.8MV/cmと高くなっています。そのため、同じ電圧定格でも、ずっと薄い膜厚で動作可能となり、ドレイン・ソースの「オン」抵抗(RDS(on))を大幅に抑えられます。
- 熱伝導率が高いため、断面積における電流密度を高くできます。
- バンドギャップ(半導体および絶縁体の価電子帯の上部から、伝導帯の下部までの電子ボルト単位のエネルギー幅)が広いため、高温でのリーク電流を低く抑えられます。こうした理由から、SiCダイオードと電界効果トランジスタ(FET)はよく、ワイドバンドギャップ(WBG)デバイスと称されます。
その結果、SiCベースのデバイスは、シリコンだけの構造に比べて最大で10倍の電圧をブロックでき、約10倍の速度でのスイッチングが可能で、同じチップ面積で25℃におけるRDS(on)が半分以下になります(もちろん、すべて概数です)。また、有害なテール電流がないため、SiCデバイスのターンオフ時のスイッチングに関わる損失も少なくなります。同時に、シリコンの125°Cに対し、SiCは約200°Cという高温での動作が可能なため、熱設計と熱管理の問題が容易になります。
SiCデバイスは、その性能特性と進歩により、IGBT、シリコンMOSFET、GaNデバイスと並んで、電力対速度のアプリケーションマトリクスで重要な位置を占めるようになりました(図2)。
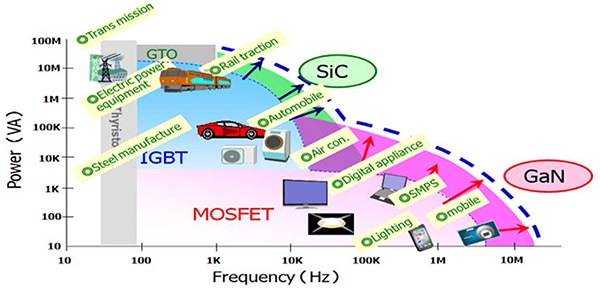 図2:SiC MOSFETの性能特性は、電力と周波数の定格を含む幅広いアプリケーションに適しています。(画像提供:Toshiba)
図2:SiC MOSFETの性能特性は、電力と周波数の定格を含む幅広いアプリケーションに適しています。(画像提供:Toshiba)
SiCの材料科学やデバイス物理の基礎から、商用SiC MOSFETまでの道のりは、決して早くも簡単でもありませんでした(図3)。その後、研究と生産の努力を重ね、2001年に最初のSiCベースデバイスであるショットキーダイオードが発表されました。その後20年間で、第1世代、第2世代、第3世代のSiC MOSFETが開発され、量産が開始されました。各世代とも、特定のパラメータの改善に狙いを定めており、トレードオフも多少異なっています。
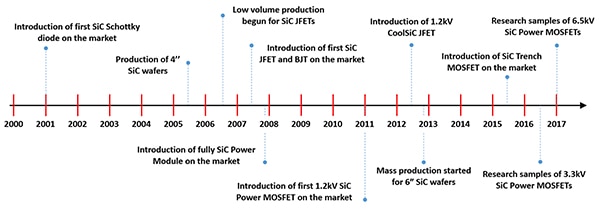 図3:2001年に登場した最初の商用SiCショットキーダイオードから、商用SiCベースデバイスの物語が始まります。(画像提供:IEEE Transactions on Industrial Electronics、2017)
図3:2001年に登場した最初の商用SiCショットキーダイオードから、商用SiCベースデバイスの物語が始まります。(画像提供:IEEE Transactions on Industrial Electronics、2017)
なお、用語について明確にすることが重要です。従来のシリコンのみのFETと同様、SiCベースのFETはMOSFETです。大ざっぱに言えば、この2つの内部の物理構造は類似しており、どちらも、ソース、ドレイン、ゲートを接続する3つ端子を持つデバイスです。違いは、名前から分かるように、SiCベースのFETでは基材に、シリコン単独ではなく、SiCを使用している点です。
第1世代、第2世代から開始
スイッチングデバイスの性能を特徴付けるパラメータは、数多く存在します。多くの静的パラメータの中には、最大動作電圧と最大電流定格に加え、特定のチップサイズとパッケージの電力処理能力に関連するRDS(on)と最大動作温度という、2つの静的な性能指数(FoM)があります。
また、スイッチングデバイスであるため、スイッチング損失を評価するために必要な動的パラメータも重要です。最もよく取り上げられる動的FoMは、RDS(on)とゲート電荷の積(RDS(on) × Qg)ですが、逆回復電荷(Qrr)もますます重要になっています。スイッチングデバイスに適切に電流を流し、オーバーシュート、リンギング、その他の歪みを発生させないために必要なゲートドライバのサイズと機能は、主にこれらのFoMによって決定されます。
第1世代のSiCデバイスでは、信頼性の問題によって使用や市場拡大が阻まれていました。そのような問題の1つは、パワーMOSFETの電源とドレインの間に配置されるPNダイオードと関係しています。PNダイオードに電圧をかけると通電し、オン抵抗が変化するため、デバイスの信頼性が低下します。
Toshibaの第2世代では、MOSFETに組み込まれたショットキーバリアダイオード(SBD)を使用することで、SiCデバイスの基本構造を変更し、この問題をほぼ解決しました(図4)。これにより、信頼性が1桁以上向上しました。新しい構造では、セル内のPNダイオードと並列にSBDを配置することにより、PNダイオードの通電を防止しました。オン状態電圧がPNダイオードよりも低いため、電流は内蔵SBDを流れ、オン抵抗の変化やMOSFETの信頼性低下が抑制されます。
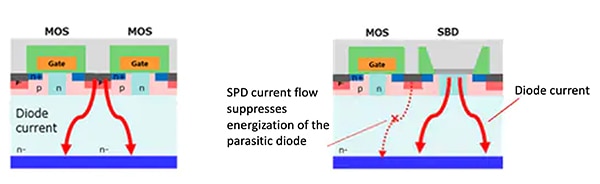 図4:ショットキーバリアダイオード(SBD)を内蔵していない一般的なSiC MOSFET(左)と異なり、内蔵しているSiC MOSFET(右)は、寄生PNダイオードの通電を最小限に抑えることができます。(画像提供:Toshiba)
図4:ショットキーバリアダイオード(SBD)を内蔵していない一般的なSiC MOSFET(左)と異なり、内蔵しているSiC MOSFET(右)は、寄生PNダイオードの通電を最小限に抑えることができます。(画像提供:Toshiba)
SBDが組み込まれたMOSFETはすでに実用化されていましたが、内蔵SBDによってオン抵抗が上昇し、高電圧製品しか許容できないレベルにまで達するため、3.3kVデバイスのような高電圧製品にしか使用されませんでした。Toshibaはさまざまなデバイスパラメータを調整し、MOSFETのSBD面積の比率がオン抵抗の増加を抑制するための鍵であることを発見しました。ToshibaはSBD比の最適化により、信頼性を大幅に向上させた1.2kVクラスのSiC MOSFETを考案しました。
しかし、多くの機能拡張と同様に、トレードオフもありました。この新しいデバイス構造は、信頼性を大幅に向上させる一方で、2つのFoMに悪影響を及ぼしました。これにより、公称RDS(on)およびRDS(on) × Qgが増加し、MOSFETの性能が低下したのです。第2世代のSiC MOSFETでは、オン抵抗を補償および低減するためにチップ面積を拡大しましたが、その分コストが高くなりました。
第3世代が示す真の成熟
このような懸念を認識したToshibaは、TWXXXN65C/TWXXXN120Cファミリと呼ばれる第3世代のSiC MOSFETデバイスを開発しました。これらのデバイスでは、電流拡散層の構造を最適化してセルサイズを縮小するだけでなく、高い電圧定格、高速スイッチング、低いオン抵抗も実現しました。
オン抵抗は、広がり抵抗(Rspread)を低減することで、ある程度低下しました。SiC MOSFETの広いP型拡散領域(Pウェル)の底に窒素を注入することで、SBD電流が増加しました。また、ToshibaはJFETの領域を縮小して窒素を注入し、帰還容量とJFET抵抗を低減しました。その結果、オン抵抗を増加させることなく、帰還容量が低減されました。さらに、SBDの配置を最適化することで、オン抵抗の変動がない安定した動作も得られました。
現在、このファミリは、400Vおよび800VのAC/DC電源、太陽光発電(PV)インバータ、無停電電源(UPS)用双方向DC/DCコンバータなどの高電力産業用アプリケーション向けに設計された、650Vおよび1200VのSiC MOSFETで構成されています。650Vと1200Vの両方のSiC MOSFETは、業界標準の3リードTO-247パッケージで提供されます(図5)。
 図5:標準のT0-247パッケージに収められたToshibaの650V/1200V第3世代SiC MOSFETは、幅広いパワー変換、制御、管理アプリケーションに適しています。(画像提供:Toshiba)
図5:標準のT0-247パッケージに収められたToshibaの650V/1200V第3世代SiC MOSFETは、幅広いパワー変換、制御、管理アプリケーションに適しています。(画像提供:Toshiba)
これらの第3世代SiC MOSFETでは、RDS(on) × Qg FoMがToshibaの第2世代デバイスと比較して80%低減されました。これは大幅な降下であり、スイッチング損失も約20%低減されました。また、内蔵ショットキーバリアダイオード技術は、超低順方向電圧(VF)ももたらします。
MOSFETに関連したデザインインの繊細さは、他にもあります。たとえば、VGSSが挙げられます。VGSSは、ドレインとソースが短絡している状態でゲート・ソース間に印加できる最大電圧です。第3世代SiCデバイスの場合、VGSSの範囲は10~25Vで、18Vを推奨値としています。広いVGSS定格は、設計の信頼性を向上させながら、設計を容易にするのに役立ちます。
さらに、低抵抗とより高いゲート閾値電圧(VGS(th)、MOSFETチャネルが導通し始める電圧)は、スパイク、グリッチ、オーバーシュートによる偶発的ターンオンなどの誤動作を防止するのに役立ちます。この電圧範囲は3.0~5.0Vのため、ドリフトを最小限に抑えて予測可能なスイッチング性能を確保するのに役立ち、シンプルなゲートドライバ設計が可能になります。
650V/1200V第3世代SiC MOSFETの詳細
650Vデバイスと1200Vデバイスというファミリスペクトラムの対極にある2つのデバイスを見ると、それらの機能の範囲がよくわかります。いずれも物理的なパッケージ、ピン配列、回路図記号は同じですが(図6)、仕様が異なります。
 図6:Toshibaの第3世代SiC MOSFETファミリのすべての製品は、物理的な配置と回路図記号が同じです。記号中の内蔵ショットキーバリアダイオードに注意してください。(画像提供:Toshiba)
図6:Toshibaの第3世代SiC MOSFETファミリのすべての製品は、物理的な配置と回路図記号が同じです。記号中の内蔵ショットキーバリアダイオードに注意してください。(画像提供:Toshiba)
650Vデバイスの1つは、100Aおよび342W定格のNチャンネルデバイスであるTW015N65Cです。一般的な仕様値は、入力容量(CISS)が4,850ピコファラッド(pF)、ゲート入力電荷(Qg)が128ナノクーロン(nC)と低く、公称RDS(on)はわずか15mΩです。
データシートには、静的および動的パラメータの最小値、標準値、最大値の表とともに、温度、ドレイン電流、ゲート・ソース間電圧(VGS)などの要因に対する重要パラメータの性能を示すグラフが記載されています。たとえば、図7には、温度、ドレイン電流(ID)、ゲート・ソース間電圧VGSに対するRDS(on)の値を示しています。
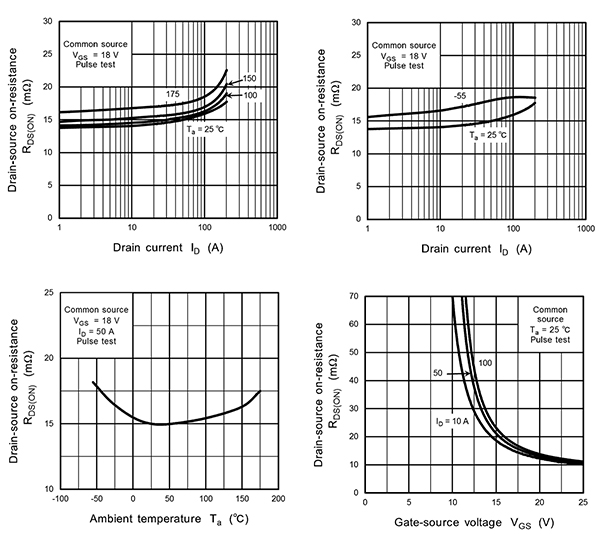 図7:ドレイン電流、周囲温度、VGSを含むさまざまな観点から、TWO15N65Cのオン抵抗を特徴付けるグラフを示しています。(画像提供:Toshiba)
図7:ドレイン電流、周囲温度、VGSを含むさまざまな観点から、TWO15N65Cのオン抵抗を特徴付けるグラフを示しています。(画像提供:Toshiba)
図8には、20A、107WのNチャンネルデバイスであるTW140N120Cなど、1200Vデバイスについても同様の仕様とグラフを示しています。このSiC MOSFETは、6000pFの低CISS、158nCのゲート入力電荷(Qg)、140mΩのRDS(on)を備えています。
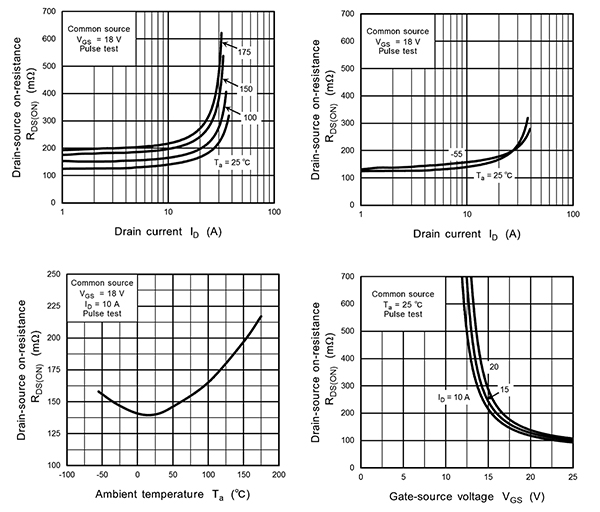 図8:TW140N120Cのオン抵抗特性グラフ。(画像提供:Toshiba)
図8:TW140N120Cのオン抵抗特性グラフ。(画像提供:Toshiba)
入手可能な第3世代のToshiba SiC MOSFETは、650Vデバイスが5製品、1200Vデバイスが5製品の合計10製品です。25℃でのオン抵抗、電流、電力定格は、以下の通りです。
650V:
- 15mΩ、100A、342W(TWO15N65C)
- 27mΩ、58A、156W
- 48mΩ、40A、132W
- 83mΩ、30A、111W
- 107mΩ、20A、70W
1200V:
- 15mΩ、100A、431W
- 30mΩ、60A、249W
- 45mΩ、40A、182W
- 60mΩ、36A、170W
- 140mΩ、20A、107W(TW140N120C)
まとめ
SiC(シリコンカーバイド)MOSFETは、シリコンのみのデバイスと比較して、重要なスイッチングパラメータが大幅に改善されています。第3世代のSiC部品は、前世代と比較して、仕様とFoMの改善、信頼性の向上、ゲートドライバ要件の特性強化、避けられないデザインインの繊細さに関する優れた洞察を提供します。このようなSiC MOSFETを使用することで、電源システムの設計者は、高効率化、小型化、性能全体の向上を実現するために使用可能な追加のコアリソースを手に入れることができます。

免責条項:このウェブサイト上で、さまざまな著者および/またはフォーラム参加者によって表明された意見、信念や視点は、DigiKeyの意見、信念および視点またはDigiKeyの公式な方針を必ずしも反映するものではありません。






